光刻(photolithography)工艺是半导体器件制造工艺中的一个重要步骤,该步骤利用曝光和显影在光刻胶层上刻画几何图形结构,然后通过刻蚀工艺将光掩模上的图形转移到所在衬底上。这里所说的衬底不仅包含硅晶圆,还可以是其他金属层、介质层,例如玻璃、蓝宝石等。
1. 曝光工艺
设备名称 | 工艺能力 |
| |
| |
| |
| |
|
2.匀胶/显影工艺
| 设备名称 | 工艺能力 |
| 自动匀胶显影机track |
|
| 手动匀胶机、热板 |
|
显影通风橱 (常温/低温显影) |
|
3.工艺展示
最小线宽150nm(步进式光刻机PAS 5500/350C) |
最小线宽40nm(电子束曝光ELS-F125G8) |
极限0.8微米线宽(MA6光刻机) |
PMMA A2曝光线条CD40nm |
最小线宽 1um(无掩膜版光刻仪 MLA) |





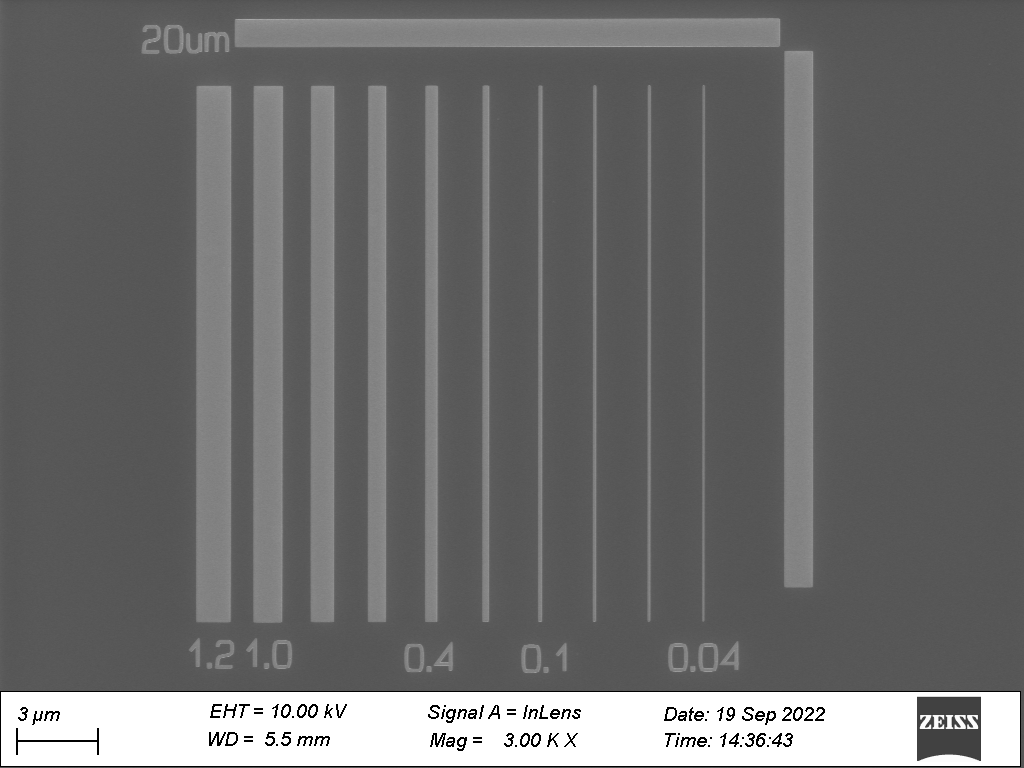




 首页
首页