量子器件中心双离子源刻蚀系统(Ion Beam Etching System)投入使用
1.设备简介
德国Scia Systems生产的型号scia Mill 150双离子源刻蚀系统。系统主要构成:离子束刻蚀机主机、真空反应腔室、离子束源、真空系统、控制系统、真空进样装置Load-Lock、SIMS二次离子质谱仪终点监测系统。
2.实验室设备展示
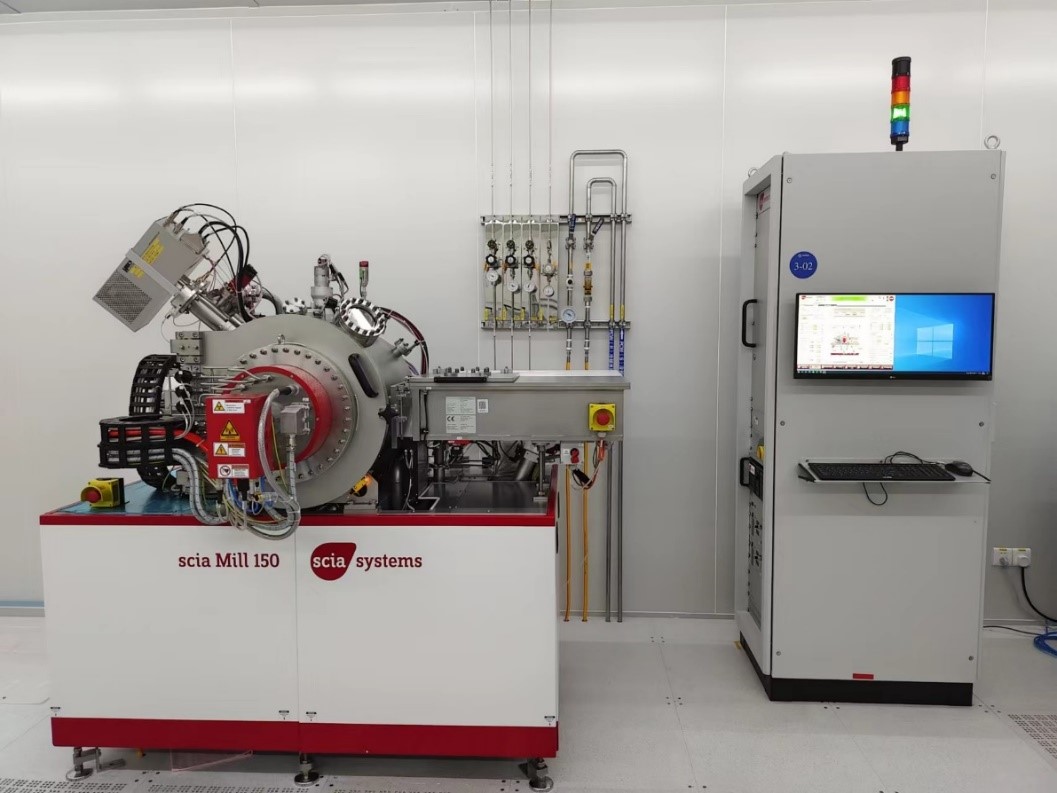
型号:scia Mill150
详细参数:
1. 工艺气体:氩气Ar;
2. 载片台背面用氦气He冷却;
3. 最大样品尺寸直径6英寸(目前是4英寸及以下样品);
4. 工艺腔本底真空≤5e-7 mbar;
5. 预真空室本底真空:20分钟内≤1e-6 mbar;
6. 离子束有效束径 ≥218mm
7. 离子束最大束压,不低于1500eV,最大束流密度可达1mA/cm2
8. 载片台,可旋转,转速可调,转速 5-20RPM;
9. 载片台,角度可倾斜,可调,范围 90~~ -60度,精度±0.1度;
10. 配HIDEN Analytical Ltd 品牌,SIMS二次离子质谱仪终点监测系统;
11. SIMS自动识别终点和设备控制融合;
12. 刻蚀速率低至15nm/min (4寸晶圆,SiO2膜);
13. 刻蚀均匀性 ≤2% (4寸晶圆,SiO2膜)。
3.基本原理
离子束刻蚀(Ion Beam Etching,IBE),也称之为离子溅射刻蚀,是利用辉光放电原理将惰性气体氩气(Ar)分解为氩离子,氩离子经过阳极电场的加速对样品表面进行物理轰击,以达到刻蚀的作用。刻蚀过程即把Ar气充入离子源放电室并使其电离形成等离子体,然后由栅极将离子呈束状引出并加速,具有一定能量的离子束进入工作室,射向固体表面轰击固体表面原子,使材料原子发生溅射,达到刻蚀目的,属纯物理刻蚀。工件表面有制备沟槽的掩膜,最后裸露的部分就会被刻蚀掉,而掩膜部分则被保留,形成所需要的沟槽图形。
离子束刻蚀使高方向性的中性离子束能够控制侧壁轮廓,优化纳米图案化过程中的径向均匀性和结构形貌。另外倾斜结构可以通过倾斜样品以改变离子束的撞击方向这一独特能力来实现。在离子束刻蚀过程中,通常情况下,样品表面采用厚胶作为掩模层,刻蚀期间富有能量的离子流会使得基片和光刻胶过热。为了便于后面光刻胶的剥离清洗,一般需要对样品台进行冷却处理,使整个刻蚀过程中温度控制在一个比较好的范围。
4.适合的材料体系
可用于刻蚀加工磁性器件中的多层金属刻蚀,各种金属(Ni、Cu、Au、Pt、Al、Ti等)及其合金,以及非金属、氧化物、氮化物等。
5.适用范围
适用于方向性好、陡直度高、刻蚀速率可控性好,分辨率高;刻蚀过程中可改变离子束入射角来控制图形轮廓,加工特殊的结构,但难以实现如ICP和RIE的高效率,高深度的刻蚀。
6.主要功能及应用
在非硅材料,在声表面波、薄膜压力传感器、红外传感器方面具有广泛应用。例如:激光光栅、高深宽比的光子晶体刻蚀、在二氧化硅、硅和金属上深沟刻蚀、微流体传感器电极、测热式微流体传感器。
7.服务描述
SQDL双离子源刻蚀系统现可为用户提供设备共享服务,开放首月机时费1元/小时,第二个月起恢复正常收费。
如果您有设备培训与使用需求,请登录官方网站至“服务指南—用户服务流程—新用户权限申请流程”中了解相关办法。
今后将为校内外客户提供各种金属材料(Ni、Cu、Au、Pt、Al、Ti等)及其合金,以及非金属、氧化物、氮化物等不同材料,多层金属堆叠等结构,纳米级浅层深度的刻蚀工艺加工服务。
设备负责人:张雁冰 zhangyb@shanghaitech.edu.cn
设备预约https://eshare.shanghaitech.edu.cn/sqdl/equipment/39292
量子器件中心简介
SQDL为上海科技大学于2019年12月设立的校级大型仪器设备共享平台,团队由业界经验丰富的工程师组成,致力于支撑上海科技大学电子、材料、物理及其交叉学科发展和人才培养工作,并为半导体和微纳器件研发领域内提供光刻、镀膜、刻蚀、后道和测试等全流程工艺研发与技术服务以及设备共享培训服务,致力于为客户提供一站式综合解决方案,目前已服务校内外企事业单位40多家、用户逾300人。
如果您有技术服务需求,欢迎垂询SQDL。
网址:https://eshare.shanghaitech.edu.cn/sqdl/





 首页
首页